3月15日,日本东丽宣布,已成功开发了一种用于混合粘接(微粘接)的绝缘树脂材料。该材料是以用于半导体和显示设备的高耐热聚酰亚胺涂层(SemicofineTM和PhotoneeceTM)为基础,将传统的聚酰亚胺涂层剂与公司的加工和粘接技术相结合,可以在混合粘接过程中提高半导体设备的产量和可靠性,并使不同芯片集成在单个封装中成为可能。
据悉,三维(3D)封装是近年来备受关注的高性能封装技术,该工艺包括半导体芯片垂直堆叠(下图1)。对于需要具有10微米或更小的凸点间距(通过焊料连接的相邻电极之间的间距)的精细结构的高性能半导体芯片而言,混合粘合十分有前景,需要在不使用凸块的情况下直接连接金属电极,从而可以进一步缩短电极间距。
目前,东丽公司销售用于3D芯片到芯片封装的树脂粘接材料,其细凸点间距约为20微米。
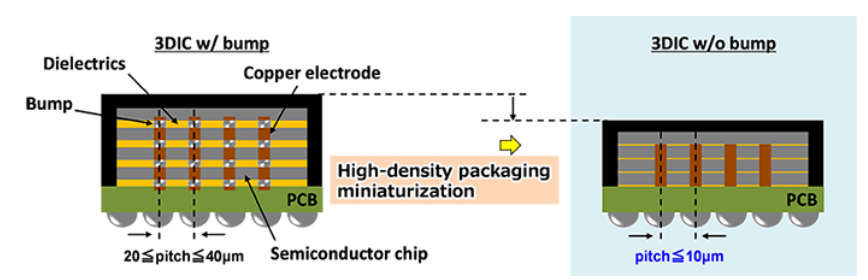
图1 3D封装横截面示意图以及有无凸起封装密度差异
在混合粘接中,芯片到晶圆片技术因其对不同类型芯片的高密度封装而受到了相当大的关注。该技术涉及将一块晶圆片基板加工成芯片大小,并将其粘接到另一块晶圆片基板上。
常用的混合粘合的绝缘材料为二氧化硅和其他无机材料通常用作,但面临两个关键挑战:其一,在芯片切割中产生的硅粉尘会在混合粘合过程中被捕获,导致芯片键合不良并降低产量;其二,残留的硅尘威胁到半导体封装的可靠性(图2)。

图2 硅粉尘对无机和有机杂化衬底的影响对比
自2020年以来,东丽公司与新加坡科学技术研究局的半导体研究部门微电子研究所进行了混合粘合实验演示,并创造出具有高耐热性和优异机械性能的绝缘聚合物(图3)。
东丽公司将用于半导体设备和电子元件的树脂产品系列中加入这种新材料,以促进高性能下一代半导体封装在高速通信设备和服务器应用中的采用。公司将推进向客户提供样品,目标在2025年获得材料认证,并在2028年开始大规模生产。

图3 在混合粘合中使用聚合物后的横截面照片
免责声明:本图文、资料来源于网络,转载的目的在于传递更多信息及分享,并不代表本网站赞同其观点和对其真实性负责,也不构成其他建议。仅供交流,不为其版权负责。如涉及侵权,请及时与我们取得联系: zpia2008@163.com。